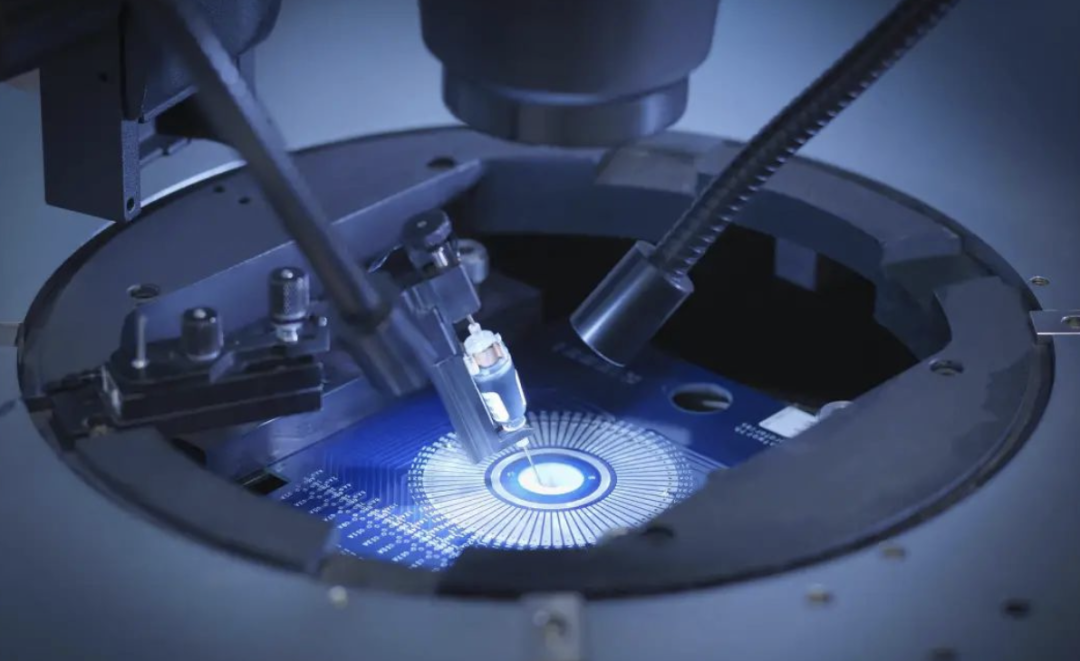
本文来自微信公众号:半导体行业观察(ID:icbank),题图:网络。
过去50多年里,半导体产业一直沿着摩尔定律向前发展,芯片工艺节点先后跨越了90nm、45nm、28nm、14nm,如今7nm和5nm已经实现量产,3nm和2nm是现在业界努力的方向,在这个不断演进的过程中,以光刻为基础的图形化工艺在其中扮演着至关重要的角色。光刻是芯片制造过程中最重要、最复杂、最昂贵的工艺,其精密度决定了芯片的制程,以及器件性能。
目前实现14nm工艺节点中的关键结构最常用的工艺是193nm沉浸式光刻结合自对准双图形(SADP)技术,但对于7nm及以下节点SADP技术已无法满足要求,必须采用四重甚至八重图形技术,这将导致成本大幅增加,而且掩膜版之间的套刻精度也难以控制。为此,学术界和工业界开始探索下一代光刻技术的解决方案。2020年国际器件与系统路线图(IRDS)将极紫外(EUV)光刻、导向自组装(DSA)和纳米压印光刻(NIL)列为下一代光刻技术的主要候选方案。EUV光刻我们都有所了解或者比较熟悉,在此我们将探讨半导体工艺技术中的另一个研发热点:DSA。
DSA先进光刻技术重回历史舞台?
DSA并不是一项新技术,早在2007年它就作为潜在的光刻解决方案登上了旧的国际半导体技术路线图 (ITRS)。2010年左右,业界开始对自下而上图案化方法DSA技术产生兴趣,甚至还引起了一番研究热潮。世界知名的代工厂如台积电、三星、英特尔、GlobalFoundries等都在自家实验室探索DSA,因为它有望解决先进光刻技术中的许多成本和复杂性问题。
但好景不长,随着业界的不断探索,他们发现这些材料容易出现缺陷。DSA材料的贴装精度也很难控制。因此,考虑到这些问题,芯片制造商便转向在晶圆厂中采用更熟悉的多重图案化技术,例如自对准双/四图案化 (SADP/SAQP)。而事实证明,没有一种光刻技术可以满足当前和未来的所有需求,SADP/SAQP也逐渐受到了挑战。尤其是随着3nm和5nm的到来,对光刻设备的需求越来越苛刻,而DSA或将作为一个补充技术而占有一席之地。
多位业内消息人士称,英特尔继续对DSA抱有浓厚的兴趣,而其它芯片制造商正在重新审视该技术。此外,一年一度的SPIE先进光刻会议,自2012年起就为嵌段共聚物DSA光刻技术设立了分论坛,供来自世界一流的企业、研究机构以及高校的相关研究者在一起进行分享、交流和讨论DSA光刻技术最新的进展与未来发展方向。由此可见,工业界对该技术高度重视并寄予厚望。
需要知道的是,DSA本身并不是一种工具技术,这是一种互补的图案化方法,可使用嵌段共聚物实现精细间距和预定义的图案。它是一种“自下而上”的光刻技术,而EUV光刻是“自上而下”。DSA能够突破传统光学光刻的衍射极限。
5nm之后,工具和技术的结合或将是产业关注的一个方向。将DSA光刻与传统的“自上而下”的EUV光刻相结合,可以提高现有光刻工艺(例如SADP/SAQP)的分辨率、修复图形缺陷和改善关键结构的特征尺寸均匀性,从而产生更高密度的半导体器件。此外,DSA光刻还有望将芯片制程推进到3nm甚至更小的技术节点。
DSA的研究进展#Human Progress
现在DSA已经取得显著进展,包括英特尔、IBM、三星等国际知名半导体企业以及IMEC、CEA-Leti 等研究机构开始针对DSA光刻技术开展了系统性的研究和产业化尝试,他们在工艺开发、整合、器件应用等方面为之努力。多个研究机构都建立了300mm晶圆DSA先导线,已经有大量的研究结果显示DSA光刻在300mm晶圆先导线上展示了优异的性能,这也为DSA光刻技术走向工业化生产迈出了重要的一步。
国内学者在DSA领域的研究也颇深,在复旦大学信息科学与工程学院胡晓华, 熊诗圣的《先进光刻技术:导向自组装》论文中指出,DSA光刻技术能够取得快速的进步与嵌段共聚物材料的发展密切相关。目前,嵌段共聚物PS-b-PMMA已成为DSA领域的“黄金标准”,PS是非极性聚合物,而PMMA属于极性聚合物。它的最小周期为22nm,用于分子自组装的机理探究以及工艺摸索,PS-b-PMMA为DSA进入工业化生产提供了强有力的理论支持与技术指导。
2016年,台积电研究团队以柱状相PS-b-PMMA为材料,采用物理外延法DSA光刻技术制备了接触孔,并对接触孔的缺陷进行了深入研究。2019年,IMECI基于PS-b-PMMA嵌段共聚物的DSA技术,生成具有低且稳定的缺陷率(即桥连和位错)的28 nm节距线/空间图案。
胡晓华, 熊诗圣的《先进光刻技术:导向自组装》论文还指出,然而,PS-b-PMMA的χ值较小(χ为俩聚合物之间的弗洛里—哈金斯相互作用参数),无法满足当前集成电路制造中10nm及以下特征尺寸的需求。为了满足工艺节点的不断发展需求,如更先进的7nm/5nm/3nm等,学术界也聚焦于合成高χ值的嵌段共聚物,如PS-b-PPC、PS-b-P2VP、PS-b-P4VP、PS-b-PAA等。这些高χ值材料经微相分离后形成的图形特征尺寸均在10nm以下,可以很好地满足目前集成电路制造的需求。
在2021年的SPIE先进光刻会议上,IMEC 首次展示了DSA图形化 的能力,使用高χ值嵌段共聚物材料制备了周期为18nm的线条光栅阵列结构,他们与TEL密切合作开发的定制干法蚀刻工艺允许将18 nm线/空间图案成功转移到足够深的 SiN 层中,以进行后续缺陷检查,而不会出现明显的线摆动或线塌陷。这些结果证实了DSA有潜力补充用于亚 2 nm技术节点的工业制造的传统自上而下图案化。
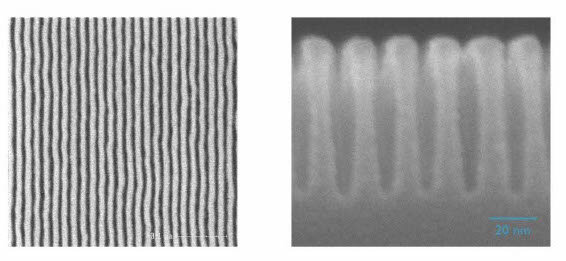
在高χ值嵌段共聚物DSA图形化和随后蚀刻到目标 SiN 层后,18nm 线/空间图案的自上而下(左)和横截面(右)SEM 图像。来源:IMEC
“近年来,DSA 吸引了大量的工业兴趣,已经发展成为一个由大学、计量学家、材料和设备供应商组成的宝贵生态系统。我们的 DSA 生态系统是我们迄今为止取得的成果的关键,”IMEC的高级图案化工艺和材料副总裁Steven Scheer说。IMEC的DSA材料的合作伙伴包括德国的Merck、美国的Brewer Science、东京电子等等。
更重要的是,2021年TEL研究团队报道了基于嵌段共聚物DSA光刻技术对化学图案上的缺陷具有一定的修复能力。嵌段共聚物为有机材料,它具有一定的柔性与可压缩性,因此对化学图案上的缺陷存在一定的容忍度。
德国的默克在2015年就已经开始试产电子级纯度的DSA材料,为 DSA光刻技术从实验室走向工业化制造不懈努力。“这项革命性技术有望彻底改变半导体制造工艺,并将加快下一代构图应用的引入。” 默克半导体解决方案全球负责人Anand Nambiar表示。2020年9月,默克在德国正式开设了新的电子应用研究中心,将致力于下一代显示和半导体材料的研发活动,其中半导体材料包括光刻胶材料、电介质和DSA材料。2021年4月,默克宣布投资2000万欧元将扩大其在日本的研发和制造基地,将建设新的基础设施,以推动和加速电子材料的创新,这个工厂所开发和制造的就包括DSA材料。
许多研究机构已经意识到DSA的优势,并希望将其应用于微电子制造中。目前,基于嵌段共聚物的DSA光刻技术已经被用于制造各种半导体器件,如鳍式场效应晶体管(FinFET)、存储器、位元图案介质和光子器件等。在SPIE上发表的一篇论文中,也指出了DSA应用于DRAM的可能性。
DSA工业化面临的挑战
上文我们叙述了DSA技术的应用前景和优势,但是DSA真正工业化仍然面临着一些挑战。在胡晓华, 熊诗圣的《先进光刻技术:导向自组装》论文中点出,DSA光刻技术应用于工业化主要分大两步,首先是采用“自上而下”的光刻工艺制备引导图形。然后,嵌段共聚物分子在制备的引导图形上进行自组装。目前进行自组装的研究已经颇多,此前一直困扰DSA光刻的缺陷问题也逐渐控制到半导体行业所能接受的范围。并已经在300mm晶圆DSA先导线上进行了实践,证明了其进入工业化的可行性。
在胡晓华, 熊诗圣的《先进光刻技术:导向自组装》论文中指出,问题主要是在引导图形上,目前关于DSA图形化工艺的计算光刻以及EDA研究非常少,这是DSA光刻工业化中所面临的最大挑战。因为在实际芯片制造中,其版图非常复杂,并不是简单的规则图形。IBM研究团队提出在芯片制造中融入DSA工艺,开发一套计算光刻工具,实现设计工艺协同优化,形成材料、设备、工艺、计算光刻、仿真模拟和EDA的完整产业链,推动DSA光刻技术真正进入工业化生产。
当然,嵌段共聚物DSA光刻技术进入工业生产,还需对DSA工艺、材料以及与现有半导体产线的兼容性问题进行全面了解。工艺方面,需要选择合适的设备,优化工艺条件,以实现高通量制造;材料方面,要保证嵌段共聚物的批量化生产、电子级纯度以及稳定性。此外,还需采用先进的设备对缺陷进行检测和分析。
任何新技术在工业化的道路上都是漫长且崎岖的,EUV光刻技术也是经历了几十多年的发展,DSA这项光刻技术无疑也将面临一些波折。不过DSA这项革新的自下而上的图形形成方法,使其在更先进的工艺节点中颇具潜力。再考虑到其对芯片制造成本上可能实现的节约,这些都将继续支撑DSA研究者们继续探索下去,我们也期待DSA真正能够助力5nm、3nm甚至更小工艺节点芯片的研发。
本内容为作者独立观点,不代表创新湾立场。如有异议,请联系创新湾。创新湾聚焦新科技、新产业,相关内容欢迎投稿。(投稿或转载请联系创新湾小编微信:LinkedBay)


发现中国科技创新的力量
创新湾ID:EnnoBay



.jpg)

